
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe în fabricarea de cipuri: un raport de știri profesionale
Evoluția materialelor semiconductoare
În domeniul tehnologiei moderne a semiconductoarelor, impulsul necruțător către miniaturizare a împins limitele materialelor tradiționale pe bază de siliciu. Pentru a satisface cerințele de înaltă performanță și consum redus de energie, SiGe (Silicon Germanium) a apărut ca un material compozit de alegere în fabricarea cipurilor semiconductoare datorită proprietăților sale fizice și electrice unice. Acest articol aprofundează înproces de epitaxiea SiGe și rolul său în creșterea epitaxială, aplicațiile de siliciu tensionat și structurile Gate-All-Around (GAA).
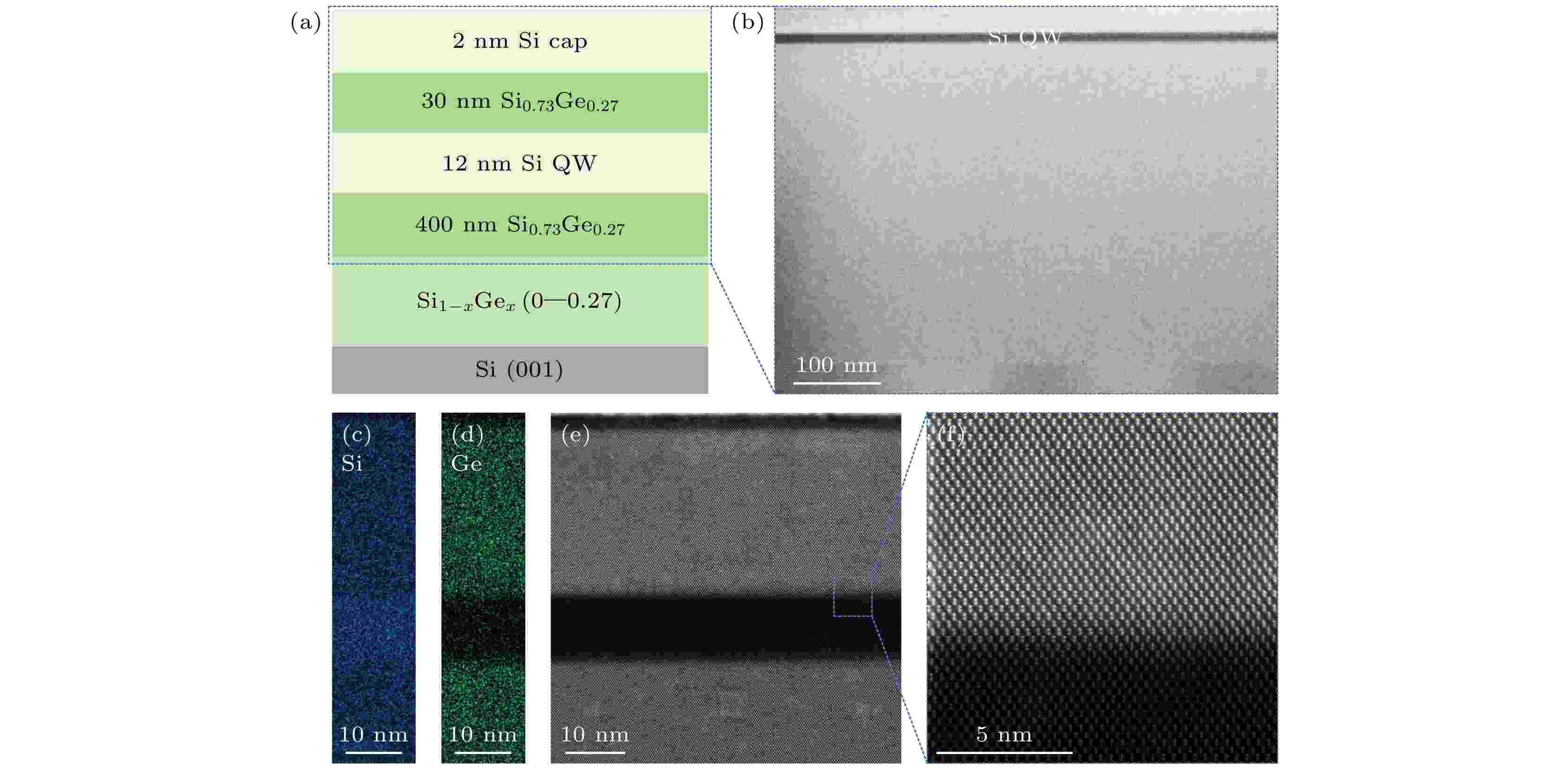
Semnificația epitaxiei SiGe
1.1 Introducere în epitaxie în fabricarea de cipuri:
Epitaxia, adesea abreviată ca Epi, se referă la creșterea unui strat monocristal pe un substrat monocristal cu același aranjament de rețea. Acest strat poate fi fiehomoepitaxial (cum ar fi Si/Si)sau heteroepitaxiale (cum ar fi SiGe/Si sau SiC/Si). Sunt folosite diferite metode pentru creșterea epitaxială, incluzând epitaxia cu fascicul molecular (MBE), depunerea prin vapori chimici în vid ultra-înalt (UHV/CVD), epitaxia atmosferică și cu presiune redusă (ATM & RP Epi). Acest articol se concentrează pe procesele de epitaxie ale siliciului (Si) și siliciului-germaniu (SiGe) utilizate pe scară largă în producția de circuite integrate semiconductoare cu siliciu ca material substrat.
1.2 Avantajele Epitaxiei SiGe:
Încorporând o anumită proporție de germaniu (Ge) în timpulproces de epitaxieformează un strat monocristal SiGe care nu numai că reduce lățimea benzii interzise, ci și crește frecvența de tăiere a tranzistorului (fT). Acest lucru îl face aplicabil pe scară largă în dispozitivele de înaltă frecvență pentru comunicații wireless și optice. Mai mult, în procesele avansate ale circuitelor integrate CMOS, nepotrivirea rețelei (aproximativ 4%) dintre Ge și Si introduce stres reticulat, sporind mobilitatea electronilor sau a găurilor și crescând astfel curentul de saturație și viteza de răspuns a dispozitivului.
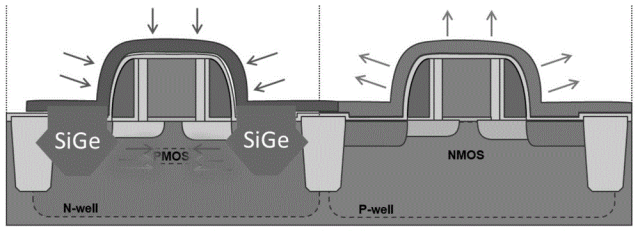
Fluxul cuprinzător al procesului de epitaxie SiGe
2.1 Pretratament:
Placile de siliciu sunt pre-tratate pe baza rezultatelor procesului dorite, implicând în primul rând îndepărtarea stratului de oxid natural și a impurităților de pe suprafața plachetei. Pentru plachetele cu substrat puternic dopate, este esențial să se ia în considerare dacă etanșarea este necesară pentru a reduce auto-dopingul în timpul ulterioare.creșterea epitaxiei.
2.2 Gaze de creștere și condiții:
Gaze de siliciu: silanul (SiH₄), diclorosilanul (DCS, SiH₂Cl₂) și triclorosilanul (TCS, SiHCl₃) sunt cele trei surse de gaz siliciu cel mai frecvent utilizate. SiH₄ este potrivit pentru procesele de epitaxie completă la temperatură joasă, în timp ce TCS, cunoscut pentru rata de creștere rapidă, este utilizat pe scară largă pentru prepararea deepitaxie de siliciustraturi.
Germaniu gaz: Germane (GeH₄) este sursa primară pentru adăugarea de germaniu, utilizată împreună cu sursele de siliciu pentru a forma aliaje SiGe.
Epitaxia selectivă: creșterea selectivă se realizează prin ajustarea ratelor relative aledepunere epitaxialăși gravarea in situ, folosind DCS gazos de siliciu care conține clor. Selectivitatea se datorează faptului că adsorbția atomilor de Cl pe suprafața siliciului fiind mai mică decât cea pe oxizi sau nitruri, facilitând creșterea epitaxială. SiH₄, lipsit de atomi de CI și cu energie de activare scăzută, se aplică în general numai proceselor de epitaxie completă la temperatură joasă. O altă sursă de siliciu folosită în mod obișnuit, TCS, are presiune de vapori scăzută și este lichidă la temperatura camerei, necesitând barbotare de H₂ pentru a o introduce în camera de reacție. Cu toate acestea, este relativ ieftin și adesea folosit pentru rata de creștere rapidă (până la 5 μm/min) pentru a crește straturi mai groase de epitaxie de siliciu, aplicate pe scară largă în producția de plachete de epitaxie de siliciu.
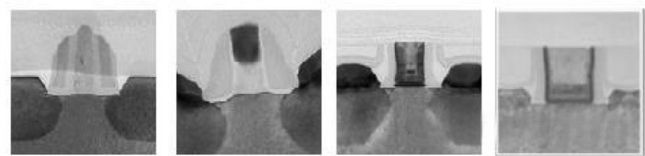
Siliciu tensionat în straturi epitaxiale
În timpulcrestere epitaxiala, epitaxial monocristal Si este depus pe un strat relaxat de SiGe. Datorită nepotrivirii rețelei dintre Si și SiGe, stratul monocristal de Si este supus la tracțiune de la stratul de SiGe subiacent, îmbunătățind semnificativ mobilitatea electronilor în tranzistoarele NMOS. Această tehnologie nu numai că crește curentul de saturație (Idsat), ci și îmbunătățește viteza de răspuns a dispozitivului. Pentru dispozitivele PMOS, straturile SiGe sunt crescute epitaxial în regiunile sursă și de scurgere după gravare pentru a introduce stres de compresiune pe canal, îmbunătățind mobilitatea orificiilor și crescând curentul de saturație.
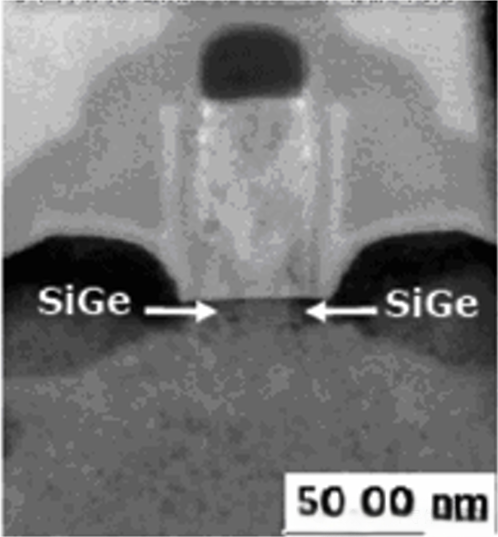
SiGe ca strat sacrificial în structurile GAA
În fabricarea tranzistoarelor nanofire Gate-All-Around (GAA), straturile SiGe acționează ca straturi de sacrificiu. Tehnicile de gravare anizotropă de înaltă selectivitate, cum ar fi gravarea stratului cvasi-atomic (quasi-ALE), permit îndepărtarea precisă a straturilor de SiGe pentru a forma structuri de nanofire sau nanofoaie.
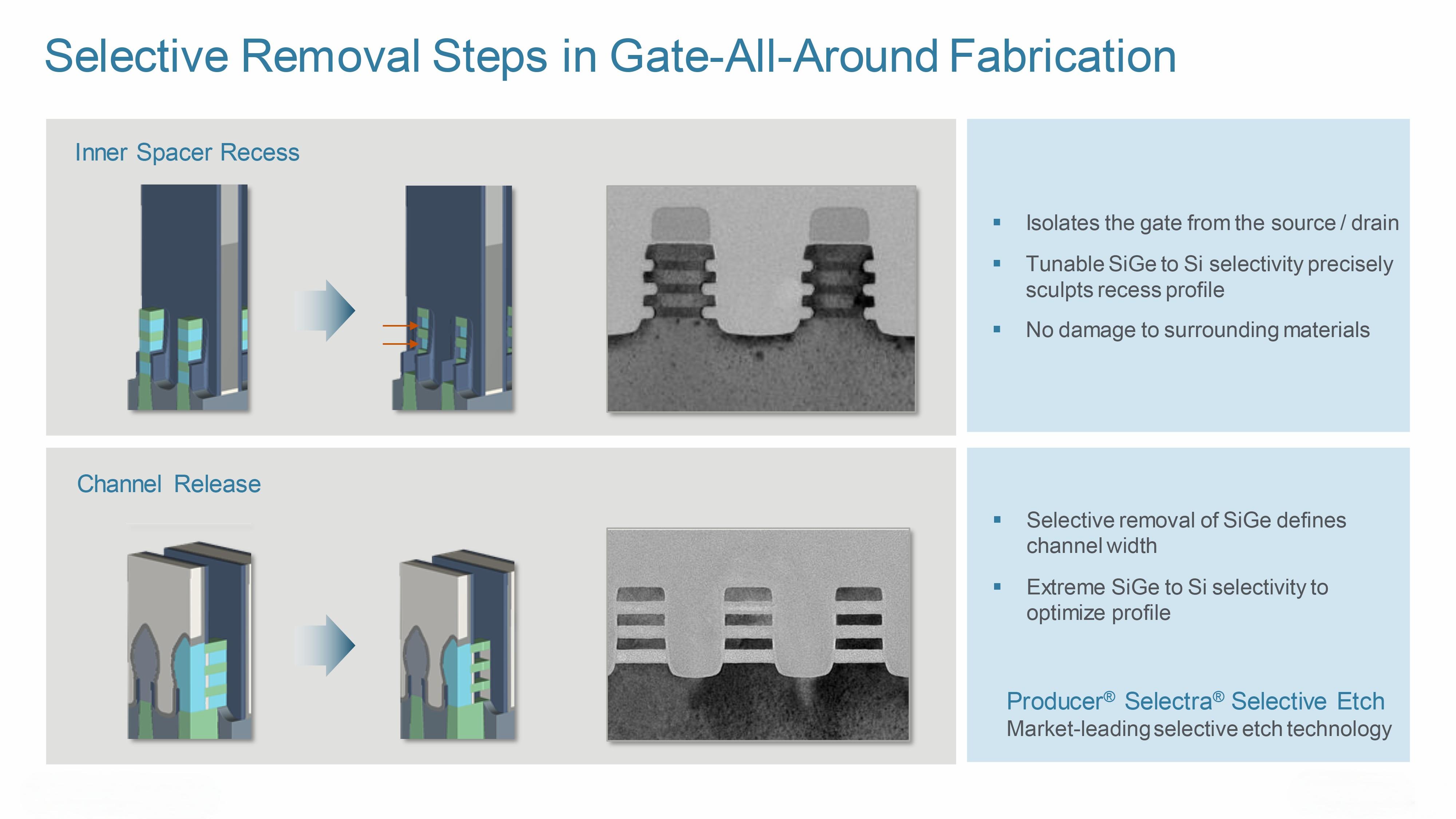
Noi, cei de la Semicorex, suntem specializați înSoluții de grafit acoperite cu SiC/TaCaplicat în creșterea epitaxială Si în producția de semiconductori, dacă aveți întrebări sau aveți nevoie de detalii suplimentare, vă rugăm să nu ezitați să ne contactați.
Telefon de contact: +86-13567891907
E-mail: sales@semicorex.com




