
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Dislocarea în cristale de SiC
Substratul SiC poate avea defecte microscopice, cum ar fi Dislocarea șurubului filetat (TSD), Dislocarea marginii filetului (TED), Dislocarea planului de bază (BPD) și altele. Aceste defecte sunt cauzate de abaterile în aranjarea atomilor la nivel atomic.
Cristalele de SiC cresc de obicei într-un mod care se extinde paralel cu axa c sau la un unghi mic cu aceasta, ceea ce înseamnă că planul c este cunoscut și ca planul de bază. Există două tipuri principale de luxații în cristal. Când linia de dislocare este perpendiculară pe planul de bază, cristalul moștenește dislocări de la cristalul sămânță în cristalul crescut epitaxial. Aceste luxații sunt cunoscute sub denumirea de luxații penetrante și pot fi clasificate în dislocații de margine de filetare (TED) și dislocații de șurub filetat (TSD) pe baza orientării vectorului Bernoulli la linia de dislocare. Dislocațiile, în care atât liniile de dislocare, cât și vectorii Brönsted sunt în planul de bază, se numesc dislocații ale planului de bază (BPD). Cristalele de SiC pot avea, de asemenea, luxații compozite, care sunt o combinație a dislocațiilor de mai sus.
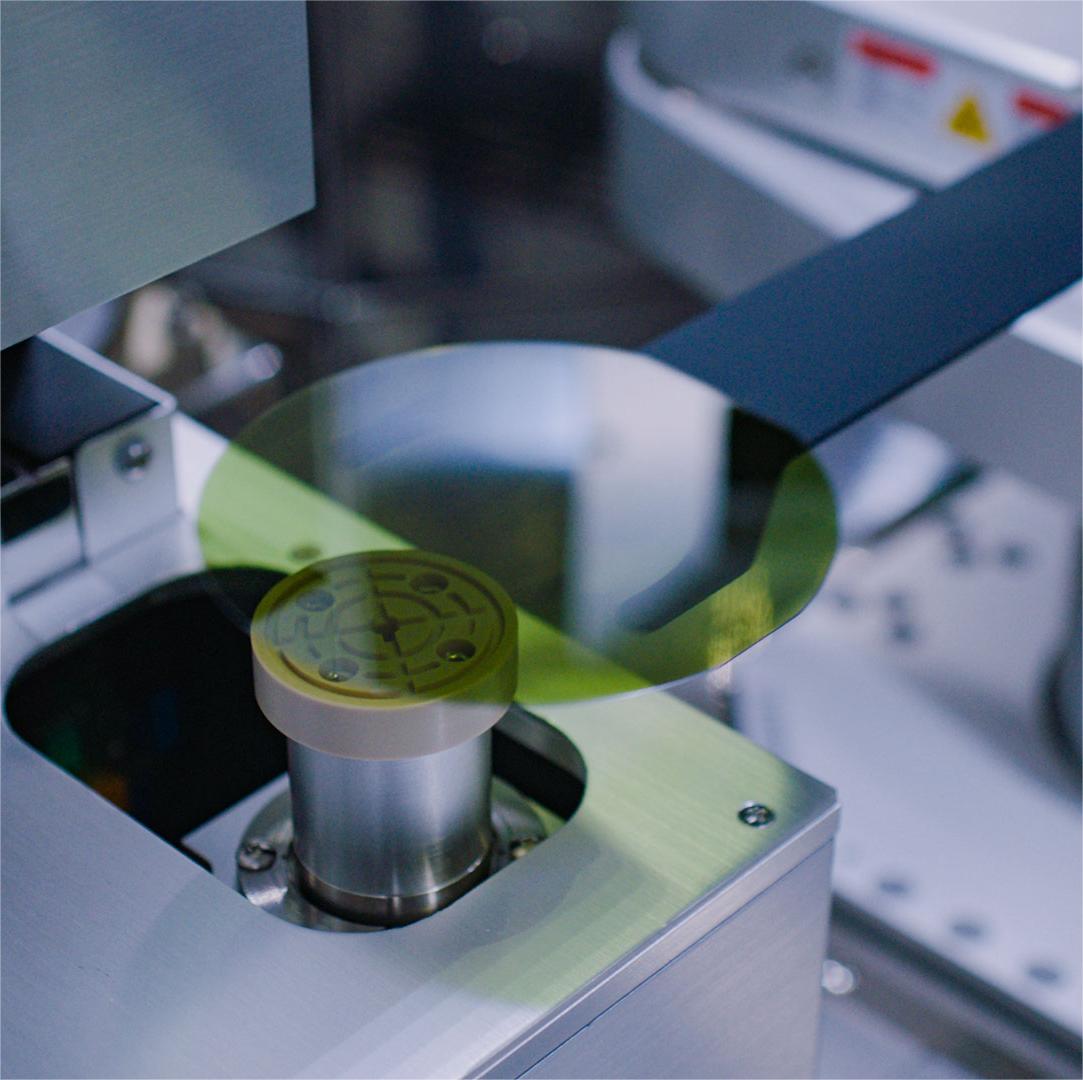
1. TED&TSD
Atât dislocațiile filetate (TSD) cât și dislocațiile filetate ale marginilor (TED) rulează de-a lungul axei de creștere [0001] cu diferiți vectori Burgers de <0001> și, respectiv, 1/3 <11-20>.
Atât TSD-urile, cât și TED-urile se pot extinde de la substrat la suprafața plachetei și produc caracteristici mici de suprafață asemănătoare gropii. De obicei, densitatea TED-urilor este de aproximativ 8.000-10.000 1/cm2, care este de aproape 10 ori mai mare decât a TSD-urilor.
În timpul procesului de creștere epitaxială SiC, TSD se extinde de la substrat la stratul epitaxial al TSD extins se poate transforma în alte defecte pe planul substratului și se poate propaga de-a lungul axei de creștere.
S-a demonstrat că în timpul creșterii epitaxiale SiC, TSD este transformată în defecte ale stratului de stivuire (SF) sau defecte de morcov pe planul substratului, în timp ce TED în stratul epitaxial se arată a fi transformat din BPD moștenit de la substrat în timpul creșterii epitaxiale.
2. BPD
Dislocațiile planului bazal (BPD), care sunt situate în planul cristalelor de SiC, au un vector Burgers de 1/3 <11-20>.
BPD-urile apar rar pe suprafața napolitanelor de SiC. Acestea sunt de obicei concentrate pe substrat la o densitate de 1500 1/cm2, în timp ce densitatea lor în stratul epitaxial este de numai aproximativ 10 1/cm2.
Se înțelege că densitatea BPD-urilor scade odată cu creșterea grosimii substratului SiC. Când sunt examinate folosind fotoluminiscență (PL), BPD-urile prezintă caracteristici liniare. În timpul procesului de creștere epitaxială SiC, BPD extins poate fi transformat în SF sau TED.
Din cele de mai sus, este evident că sunt prezente defecte în placa de substrat SiC. Aceste defecte pot fi moștenite în creșterea epitaxială a peliculelor subțiri, care pot provoca deteriorarea fatală a dispozitivului SiC. Acest lucru poate duce la pierderea avantajelor SiC, cum ar fi un câmp mare de defalcare, tensiune inversă mare și curent de scurgere scăzut. În plus, acest lucru poate reduce rata de calificare a produsului și poate pune obstacole uriașe în calea industrializării SiC din cauza fiabilității reduse.




