
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Creștere epitaxială fără defecte și luxații neadaptate
Creștere epitaxială fără defecte apare atunci când o rețea cristalină are constante ale rețelei aproape identice cu alta. Creșterea are loc atunci când situsurile de rețea ale celor două rețele de la regiunea interfeței sunt aproximativ egale, ceea ce este posibil cu o nepotrivire mică a rețelei (mai puțin de 0,1%). Această potrivire aproximativă este realizată chiar și cu deformarea elastică la interfață, unde fiecare atom este ușor deplasat față de poziția sa inițială în stratul limită. În timp ce o cantitate mică de deformare este tolerabilă pentru straturile subțiri și chiar de dorit pentru laserele cu godeuri cuantice, energia de deformare stocată în cristal este în general redusă prin formarea de dislocații neadaptate, care implică un rând lipsă de atomi într-o rețea.

Figura de mai sus ilustrează o schemă ao luxație neadaptată formată în timpul creșterii epitaxiale pe un plan cubic (100)., unde cei doi semiconductori au constante de rețea ușor diferite. Dacă a este constanta rețelei a substratului și a’ = a − Δa este cea a stratului în creștere, atunci distanța dintre fiecare rând de atomi lipsă este de aproximativ:
L ≈ a2/A
La interfața celor două rețele, rândurile lipsă de atomi există de-a lungul a două direcții perpendiculare. Distanța dintre rânduri de-a lungul axelor principale de cristal, cum ar fi [100], este dată aproximativ de formula de mai sus.
Acest tip de defect la interfață se numește dislocare. Deoarece apare din nepotrivirea rețelei (sau nepotrivire), se numește luxație nepotrivită sau pur și simplu dislocare.
În vecinătatea dislocațiilor neadaptate, rețeaua este imperfectă cu multe legături suspendate, ceea ce poate duce la recombinarea neradiativă a electronilor și a găurilor. Prin urmare, pentru fabricarea dispozitivelor optoelectronice de înaltă calitate, sunt necesare straturi nepotrivite fără dislocare.
Generarea luxațiilor nepotrivite depinde de nepotrivirea rețelei și de grosimea stratului epitaxial crescut. Dacă nepotrivirea rețelei Δa/a este în intervalul de la -5 × 10-3 la 5 × 10-3, atunci nu se formează dislocații nepotrivite în InGaAsP-InP dublu straturi de heterostructură (0,4 µm grosime) crescute pe (100) InP.
Apariția dislocațiilor în funcție de nepotrivirea rețelei pentru diferite grosimi ale straturilor de InGaAs crescute la 650°C pe (100) InP este prezentată în figura de mai jos.
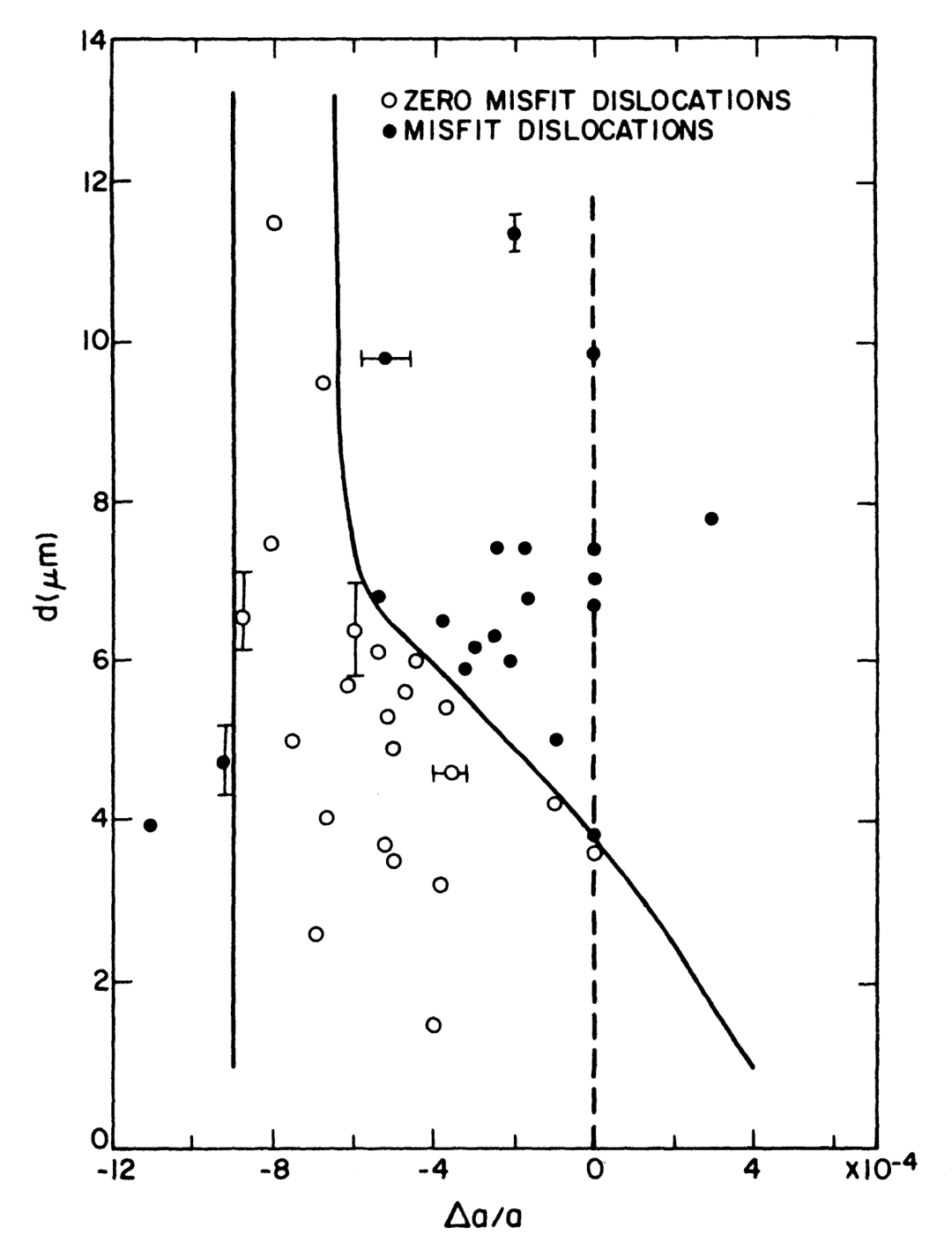
Această figură ilustreazăapariția dislocațiilor nepotrivite ca o funcție a nepotrivirii rețelei pentru diferite grosimi ale straturilor de InGaAs crescute de LPE pe (100) InP. Nu se observă dislocații neadaptate în regiunea delimitată de linii continue.
După cum se arată în figura de mai sus, linia continuă reprezintă limita unde nu s-au observat dislocații. Pentru creșterea straturilor groase de InGaAs fără dislocare, nepotrivirea tolerabilă a rețelei la temperatura camerei este între -6,5 × 10-4 și -9 × 10-4 .
Această nepotrivire negativă a rețelei apare din cauza diferenței dintre coeficienții de dilatare termică ai InGaAs și InP; un strat perfect potrivit la temperatura de creștere de 650°C va avea o nepotrivire negativă a rețelei la temperatura camerei.
Deoarece dislocațiile neadaptate se formează în jurul temperaturii de creștere, potrivirea rețelei la temperatura de creștere este importantă pentru creșterea straturilor fără dislocare.**




