
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Înțelegerea procesului complet de fabricare a dispozitivelor semiconductoare
1. Fotolitografie
Fotolitografia, adesea sinonimă cu generarea de modele, este una dintre cele mai critice forțe motrice din spatele progresului rapid al tehnologiei semiconductoarelor, care provine din procesele de fabricare a plăcilor fotografice în imprimare. Această tehnică permite prezentarea oricărui model la scară micro sau nano, folosind fotorezist și, atunci când este combinat cu alte tehnologii de proces, transferă aceste modele pe materiale, realizând diferite modele și concepte de materiale și dispozitive semiconductoare. Sursa de lumină utilizată în fotolitografie influențează direct precizia modelelor, cu opțiuni variind de la ultraviolete, ultraviolete profunde, la raze X și fascicule de electroni, fiecare corespunzând nivelurilor crescânde de fidelitate a modelului în ordinea menționată.
Un flux de proces de fotolitografie standard include pregătirea suprafeței, aderența, coacerea moale, expunerea, coacerea post-expunere, dezvoltarea, coacerea tare și inspecția.
Tratarea suprafeței este imperativă, deoarece substraturile absorb de obicei moleculele de H2O din aer, ceea ce este dăunător pentru fotolitografie. Prin urmare, substraturile sunt supuse inițial procesării de deshidratare prin coacere.
Pentru substraturile hidrofile, aderența lor la fotorezistul hidrofob este insuficientă, cauzând potențial detașarea fotorezistului sau nealinierea modelului, deci necesitatea unui promotor de aderență. În prezent, hexametil disilazanul (HMDS) și tri-metil-silil-dietil-amină (TMSDEA) sunt intensificatori de aderență utilizați pe scară largă.
După tratarea suprafeței, începe aplicarea fotorezistului. Grosimea fotorezistului aplicat nu este legată doar de vâscozitatea acestuia, ci este afectată și de viteza de acoperire prin centrifugare, în general invers proporțională cu rădăcina pătrată a vitezei de centrifugare. După acoperire, se efectuează o coacere moale pentru a evapora solventul din fotorezist, îmbunătățind aderența într-un proces cunoscut sub numele de precoace.
Odată ce acești pași sunt finalizați, are loc expunerea. Fotorezistele sunt clasificate ca pozitive sau negative, cu proprietăți opuse după expunere.
Luați fotorezistul pozitiv ca exemplu, unde fotorezistul neexpus este insolubil în revelator, dar devine solubil după expunere. În timpul expunerii, sursa de lumină, care trece printr-o mască cu model, luminează substratul acoperit, modelând fotorezistul. De obicei, substratul trebuie aliniat cu masca înainte de expunere pentru a controla cu precizie poziția de expunere. Durata expunerii trebuie gestionată cu strictețe pentru a preveni denaturarea modelului. După expunere, ar putea fi necesară o coacere suplimentară pentru a atenua efectele undelor staţionare, deşi acest pas este opţional şi poate fi ocolit în favoarea dezvoltării directe. Dezvoltarea dizolvă fotorezistul expus, transferând modelul măștii cu precizie pe stratul de fotorezist. Timpul de dezvoltare este, de asemenea, critic – prea scurt duce la o dezvoltare incompletă, prea lung provoacă distorsiuni de tipar.
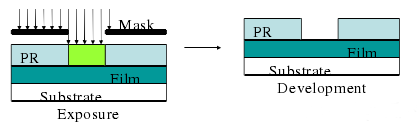
Ulterior, coacerea dură întărește atașarea filmului fotorezistent pe substrat și îi îmbunătățește rezistența la gravare. Temperatura de coacere tare este, în general, puțin mai mare decât cea a coacerii prealabile.
În cele din urmă, inspecția microscopică verifică dacă modelul se aliniază cu așteptările. După ce modelul este transferat pe material prin alte procese, fotorezistul și-a îndeplinit scopul și trebuie îndepărtat. Metodele de stripare includ umed (folosind solvenți organici puternici, cum ar fi acetona) și uscat (folosind plasmă de oxigen pentru a grava filmul).
2. Tehnici de dopaj
Dopajul este indispensabil în tehnologia semiconductoarelor, modificând proprietățile electrice ale materialelor semiconductoare după cum este necesar. Metodele comune de dopaj includ difuzia termică și implantarea ionică.
(1) Implantarea ionică
Implantarea ionică dopează substratul semiconductor bombardându-l cu ioni de înaltă energie. În comparație cu difuzia termică, are multe avantaje. Ionii, selectați de un analizor de masă, asigură o puritate ridicată de dopaj. Pe toată durata implantării, substratul rămâne la temperatura camerei sau puțin peste. Pot fi utilizate multe filme de mascare, cum ar fi dioxid de siliciu (SiO2), nitrură de siliciu (Si3N4) și fotorezist, oferind o flexibilitate ridicată cu tehnici de masca auto-aliniate. Dozele de implant sunt controlate cu precizie, iar distribuția ionilor de impurități implantate este uniformă în același plan, rezultând o repetabilitate ridicată.
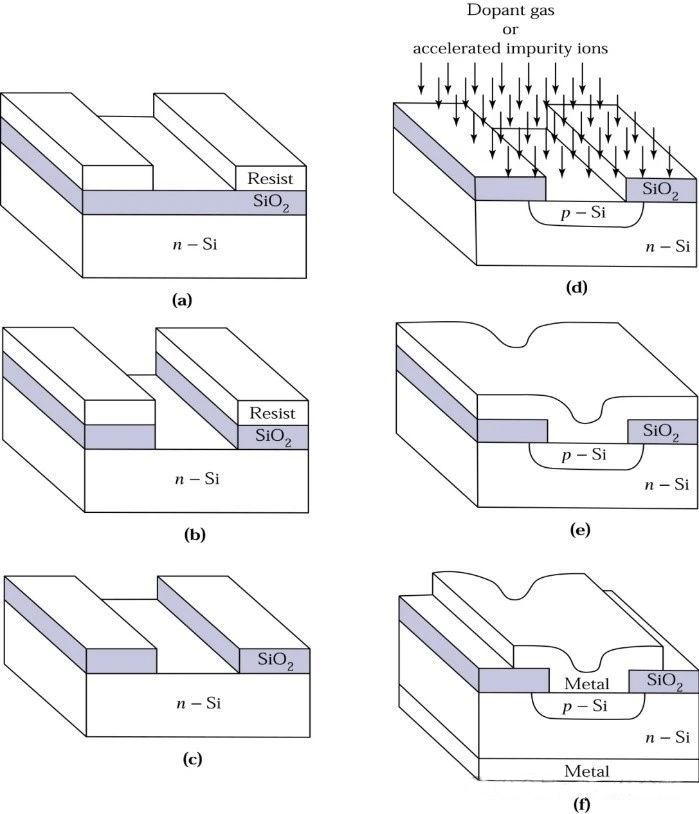
Adâncimea de implantare este determinată de energia ionilor. Prin reglarea energiei și a dozei, distribuția ionilor de impurități în substrat după implantare poate fi manipulată. Implantări multiple cu scheme variate pot fi efectuate continuu pentru a realiza diferite profiluri de impurități. În special, în substraturile cu un singur cristal, dacă direcția de implantare este paralelă cu direcția cristalografică, apar efecte de canalizare - unii ioni vor călători de-a lungul canalelor, ceea ce face ca controlul adâncimii să fie dificil.
Pentru a preveni canalizarea, implantarea este de obicei efectuată la un unghi de aproximativ 7° față de axa principală a substratului monocristal sau prin acoperirea substratului cu un strat amorf.
Cu toate acestea, implantarea ionică poate deteriora semnificativ structura cristalină a substratului. Ionii de înaltă energie, la ciocnire, transferă energie către nucleele și electronii substratului, determinându-i să părăsească rețeaua și să formeze perechi de defecte interstițiale-vacante. În cazuri severe, structura cristalină din unele regiuni poate fi distrusă, formând zone amorfe.
Deteriorarea rețelei afectează foarte mult proprietățile electrice ale materialului semiconductor, cum ar fi reducerea mobilității purtătorilor sau durata de viață a purtătorilor neechilibrați. Cel mai important, majoritatea impurităților implantate ocupă locuri interstițiale neregulate, nereușind să formeze dopaje eficiente. Prin urmare, repararea daunelor rețelei postimplantare și activarea electrică a impurităților sunt esențiale.
(2)Procesare termică rapidă (RTP)
Recoacere termică este cea mai eficientă metodă pentru a repara daunele rețelei cauzate de implantarea ionilor și de impuritățile care activează electric. La temperaturi ridicate, perechile de defecte interstițiale-vacante din rețeaua cristalină a substratului se vor recombina și vor dispărea; regiunile amorfe se vor recristaliza, de asemenea, de la granița cu zone monocristaline prin epitaxie în fază solidă. Pentru a preveni oxidarea materialului substratului la temperaturi ridicate, recoacerea termică trebuie efectuată într-o atmosferă de vid sau gaz inert. Recoacere tradițională durează mult timp și poate provoca o redistribuire semnificativă a impurităților din cauza difuziei.
Apariția luiTehnologia RTPabordează această problemă, realizând în mare măsură repararea daunelor rețelei și activarea impurităților într-o durată de recoacere scurtată.
În funcție de sursa de căldură,RTPeste clasificată în mai multe tipuri: scanare cu fascicule de electroni, fascicule de electroni și ioni pulsați, lasere pulsate, lasere cu undă continuă și surse de lumină incoerentă în bandă largă (lămpi cu halogen, încălzitoare cu grafit, lămpi cu arc), acestea din urmă fiind cele mai utilizate. Aceste surse pot încălzi substratul la temperatura necesară într-o clipă, completând recoacerea într-un timp scurt și reducând eficient difuzia impurităților.
3. Tehnici de depunere a filmului
(1) Depunere chimică în vapori îmbunătățită cu plasmă (PECVD)
PECVD este o formă de tehnică de depunere în vapori chimici (CVD) pentru depunerea filmului, celelalte două fiind CVD la presiune atmosferică (APCVD) și CVD la presiune joasă (LPCVD).
În prezent, PECVD este cel mai larg aplicat dintre cele trei tipuri. Utilizează plasmă de radiofrecvență (RF) pentru a iniția și susține reacții chimice la temperaturi relativ scăzute, facilitând astfel depunerea filmului la temperatură scăzută cu rate mari de depunere. Schema echipamentului său este așa cum este ilustrată.
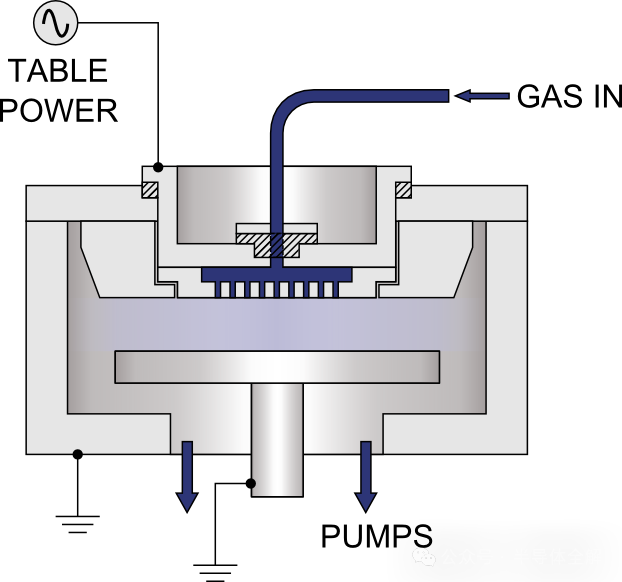
Filmele produse prin această metodă prezintă proprietăți electrice și de aderență excepționale, microporozitate minimă, uniformitate ridicată și capacități robuste de umplere la scară mică. Factorii care afectează calitatea depunerii PECVD includ temperatura substratului, debitul de gaz, presiunea, puterea RF și frecvența.
(2) Pulverizare
Pulverizarea este o metodă de depunere fizică în vapori (PVD). Ionii încărcați (în mod obișnuit ionii de argon, Ar+) sunt accelerați într-un câmp electric, câștigând energie cinetică. Ele sunt îndreptate către materialul țintă, ciocnind cu moleculele țintă și determinându-le să se disloce și să se îndepărteze. Aceste molecule posedă, de asemenea, o energie cinetică semnificativă și se deplasează spre substrat, depunându-se pe acesta.

Sursele de putere de pulverizare utilizate în mod obișnuit includ curentul continuu (DC) și frecvența radio (RF), unde pulverizarea în curent continuu este direct aplicabilă materialelor conductoare precum metalele, în timp ce materialele izolatoare necesită pulverizare RF pentru depunerea filmului.
Pulverizarea convențională suferă de rate scăzute de depunere și presiuni mari de lucru, rezultând o calitate mai scăzută a filmului. Pulverizarea cu magnetron abordează aceste probleme în mod mai ideal. Utilizează un câmp magnetic extern pentru a modifica traiectoria liniară a ionilor într-o cale elicoidală în jurul direcției câmpului magnetic, prelungind calea acestora și îmbunătățind eficiența coliziunii cu moleculele țintă, sporind astfel eficiența pulverizării. Acest lucru are ca rezultat rate crescute de depunere, presiuni de lucru reduse și calitatea filmului îmbunătățită semnificativ.
4. Gravurare Tehnici
Gravarea este clasificată în moduri uscate și umede, denumite pentru utilizarea (sau, respectiv, lipsa) de soluții specifice.
De obicei, gravarea necesită pregătirea unui strat de mască (care poate fi direct fotorezistent) pentru a proteja regiunile care nu sunt destinate gravării.
(1) Gravare uscată
Tipurile comune de gravare uscată includGravare cu plasmă cuplată inductiv (ICP)., Ion Beam Etching (IBE) și Reactive Ion Etching (RIE).
În gravarea ICP, plasma produsă prin descărcare strălucitoare conține numeroși radicali liberi foarte activi din punct de vedere chimic (atomi liberi, molecule sau grupuri atomice), care reacționează chimic cu materialul țintă pentru a forma produse volatile, realizând astfel gravarea.
IBE folosește ioni de înaltă energie (ionizați din gaze inerte) pentru a bombarda direct suprafața materialului țintă pentru gravare, reprezentând un proces fizic.
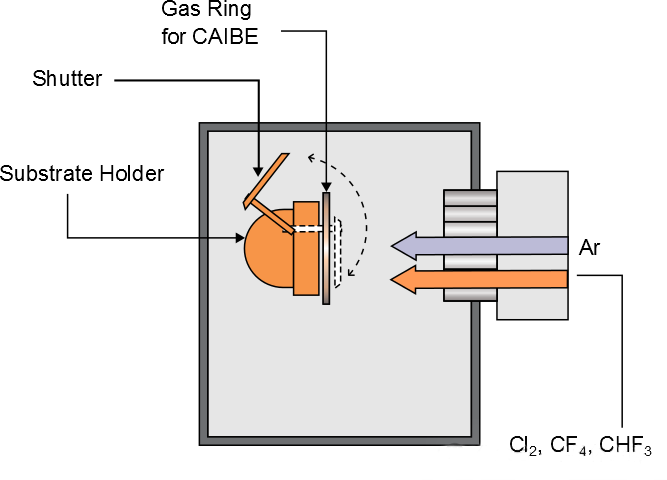
RIE este considerată o combinație a celor două anterioare, înlocuind gazul inert utilizat în IBE cu gazul utilizat în gravarea ICP, constituind astfel RIE.
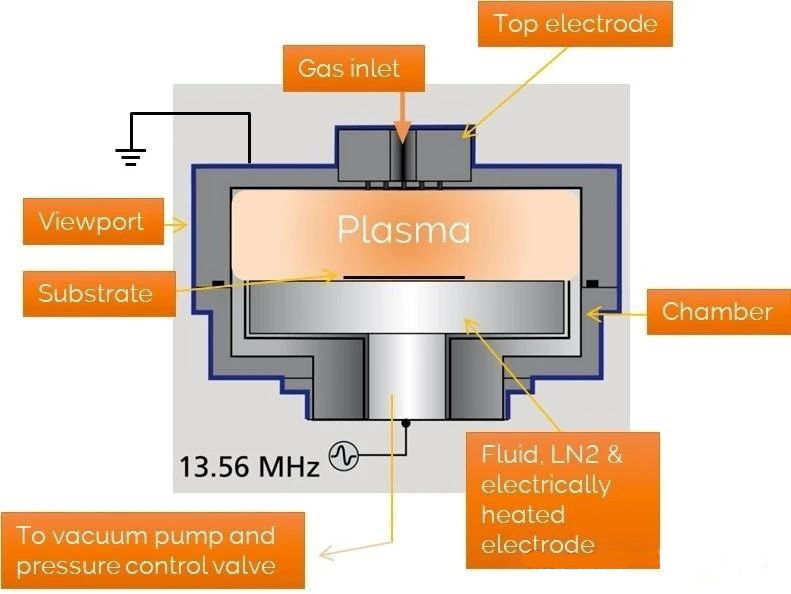
Pentru gravarea uscată, rata de gravare verticală depășește cu mult rata laterală, adică are un raport de aspect ridicat, permițând replicarea precisă a modelului măștii. Cu toate acestea, gravarea uscată gravează, de asemenea, stratul de mască, arătând o selectivitate mai slabă (raportul ratelor de gravare a materialului țintă față de stratul de mască), în special cu IBE, care poate grava neselectiv pe suprafața materialului.
(2) Gravare umedă
Gravarea umedă denotă metoda de gravare realizată prin scufundarea materialului țintă într-o soluție (gravare) care reacționează chimic cu acesta.
Această metodă de gravare este simplă, rentabilă și prezintă o selectivitate bună, dar are un raport de aspect scăzut. Materialul de sub marginile măștii poate fi corodat, făcându-l mai puțin precis decât gravarea uscată. Pentru a atenua impactul negativ al unui raport de aspect scăzut, trebuie alese rate adecvate de gravare. Factorii care influențează viteza de decapare includ concentrația de gravare, timpul de gravare și temperatura de gravare.**




